热线电话:0755-23712116
邮箱:contact@shuangyi-tech.com
地址:深圳市宝安区沙井街道后亭茅洲山工业园工业大厦全至科技创新园科创大厦2层2A
1.晶圆缺陷粒子检测系统
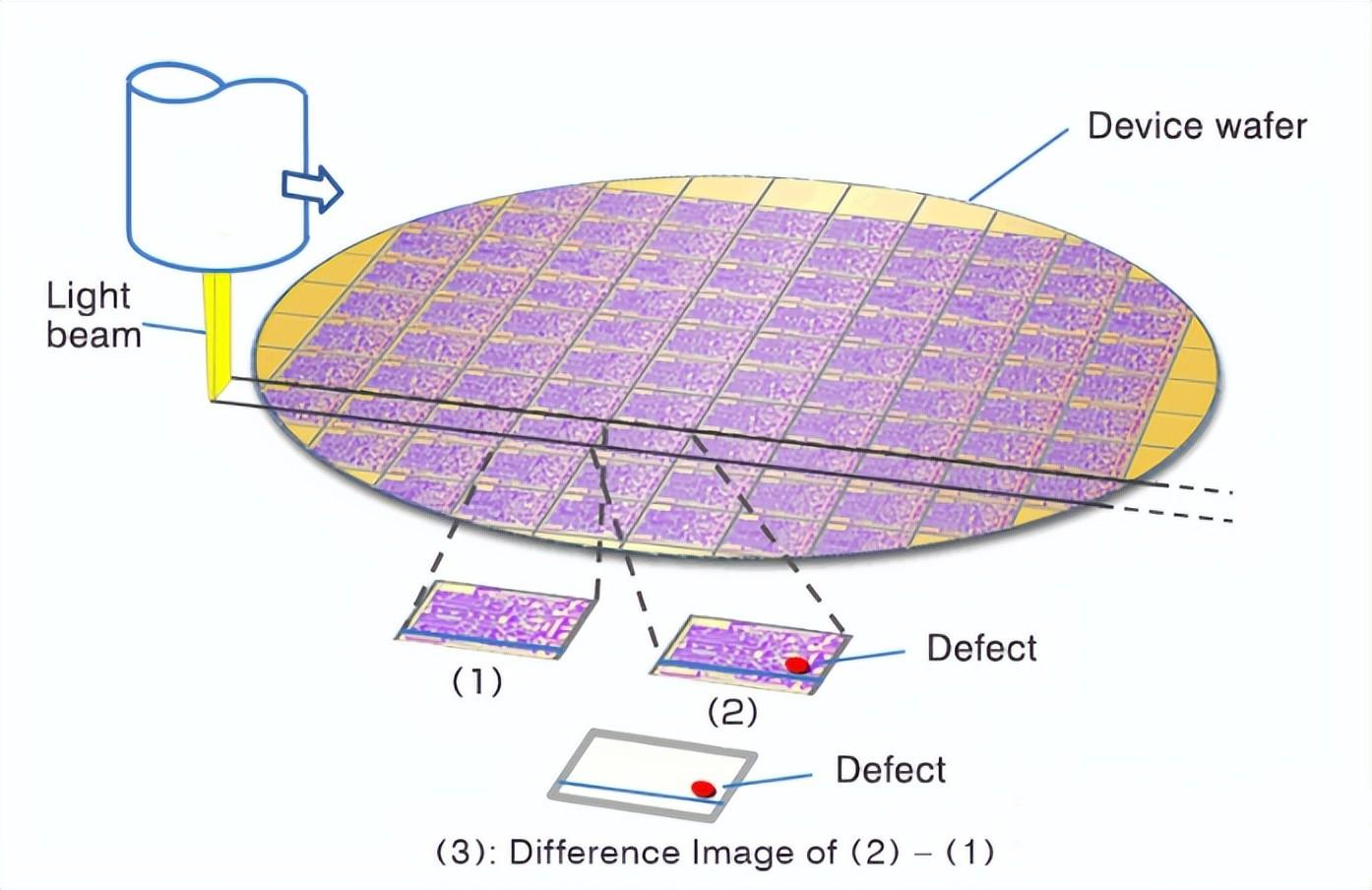
颗粒和缺陷:颗粒和缺陷导致晶圆表面不规则形貌。
散射入射光:通过检测散射光来监测颗粒和缺陷。

晶圆缺陷检测系统可以通过获取缺陷的(X,Y)坐标来检测晶圆上的物理缺陷(颗粒)和图案缺陷并绘制map,这些颗粒可以借助光散射现象来检测:

1)激光束在椭圆镜的一个焦点处垂直扫描晶圆表面,光电探测器放置在另一焦点处;
2)移动晶圆,收集散射光以检测微小颗粒和缺陷;
3)绘制晶圆表面上的颗粒/缺陷位置图。

→一般由一种使用粒子计数器测量粒子的设备。
缺陷可分为随机缺陷和系统缺陷。
→随机缺陷主要是由附着在晶圆上的颗粒引起的,因此无法预测其位置。
一般来说,系统性缺陷出现在mask状况和曝光过程中。因此,它发生在所有接收光刻芯片的电路pattern中的同一位置。
2.明场成像/暗场成像
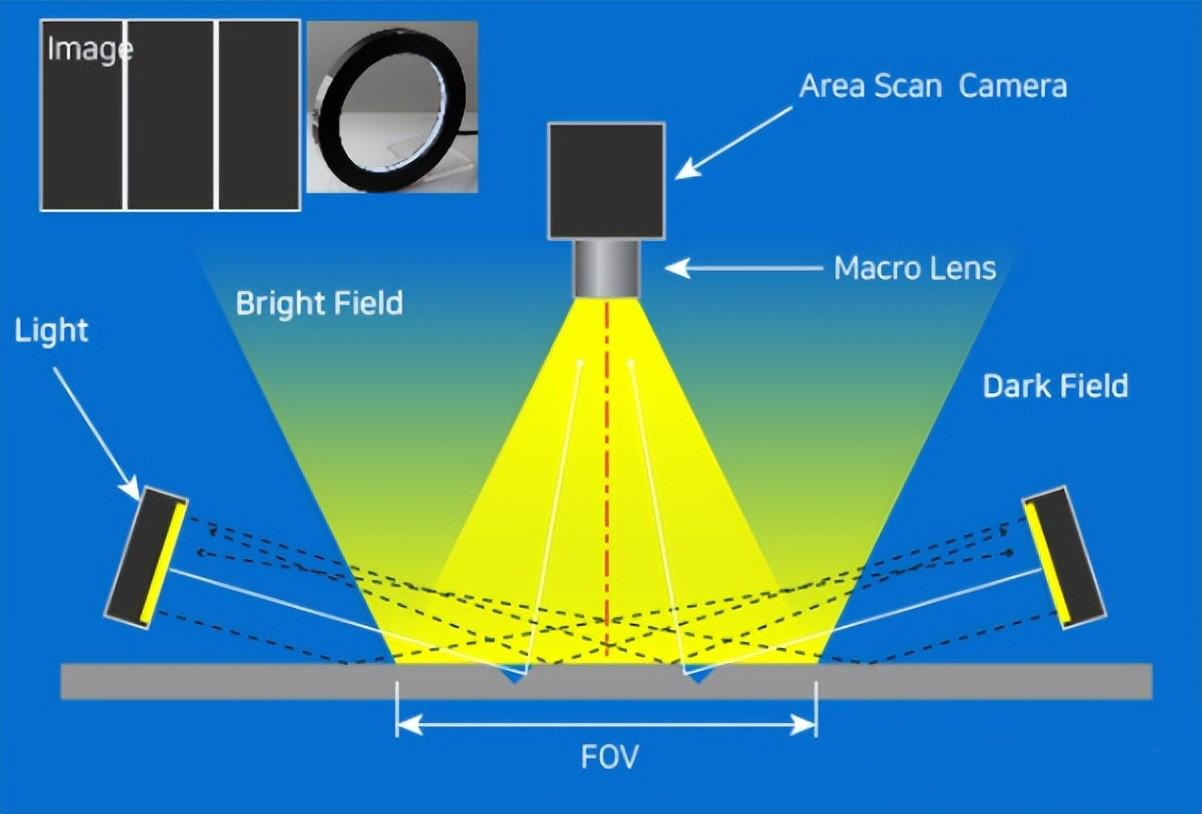
暗场法是一种使用散射光的测量方法。当光线照射到某个物体时,它会引起散射和反射,可以说它是一种利用这种散射光快速确定结构存在与否的方法。该结构在透镜的视角(FOV)之外(主要在0~45度之间)安装激光源,当光线照射时,散射光进入透镜并识别物体。结构变亮,不存在的部分显得很暗。当然,分辨率低于反射(Bright)类型,因为使用了散射光,但是可以快速拾取图案边缘的形状,因此Fab里主要用暗场而不是明场。暗场中使用的光源使用波长比亮波长长的紫外线。
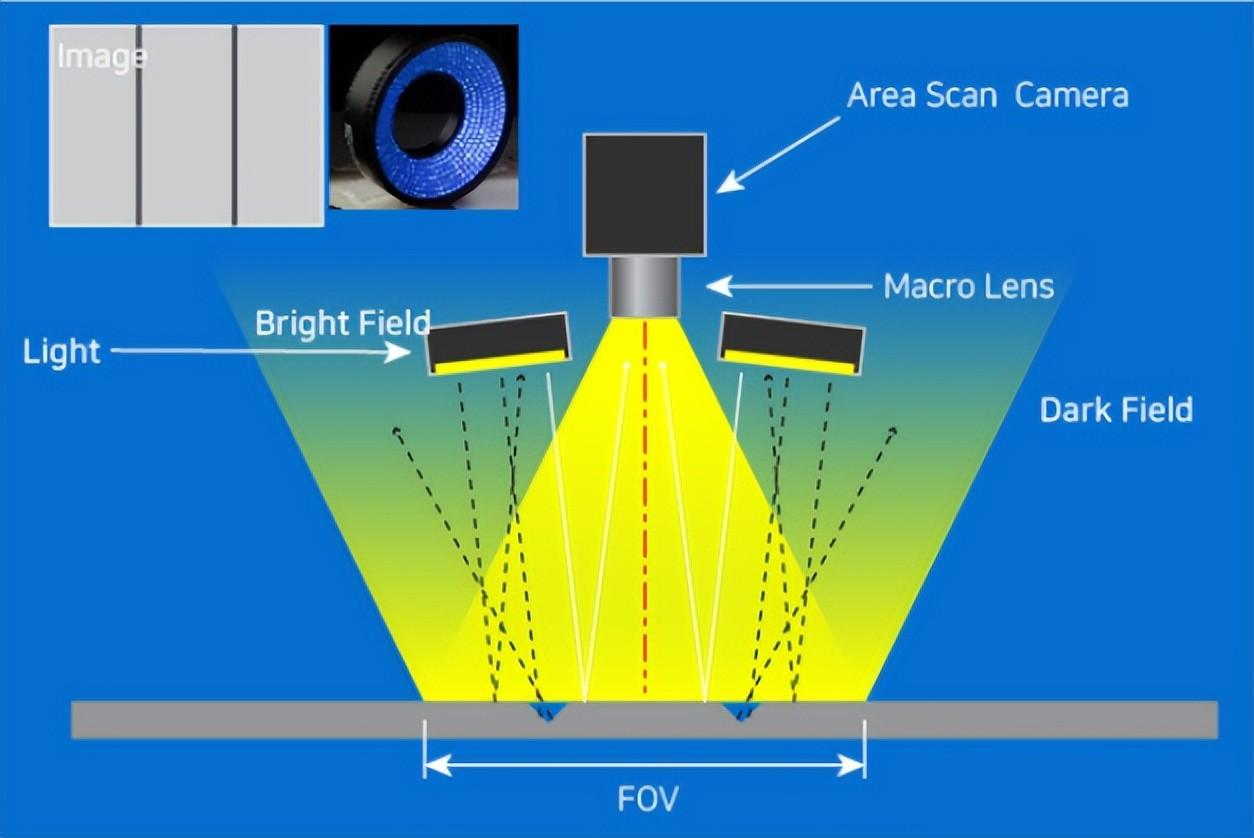
明场法是一种使用反射光的测量方法。该结构是一种在微透镜视角下创建和照射激光源的方法。然后,它接收反射光,反射光是明亮的,如果有结构,它就会被散射,所以结构显得黑暗。使用短波长的DUV作为光源,分辨率好,但通放不如暗场,因此用于具有精细图案的晶圆的检查。
→结论:明场成像用于精确检查缺陷。此外,暗场成像可以高速检测,用于大量晶圆的缺陷测试。
根据透镜系统的位置,分为直接检测散射光的暗场成像和检测反射光强度损失的明场成像,如下图所示:

3.图案化晶圆检测系统
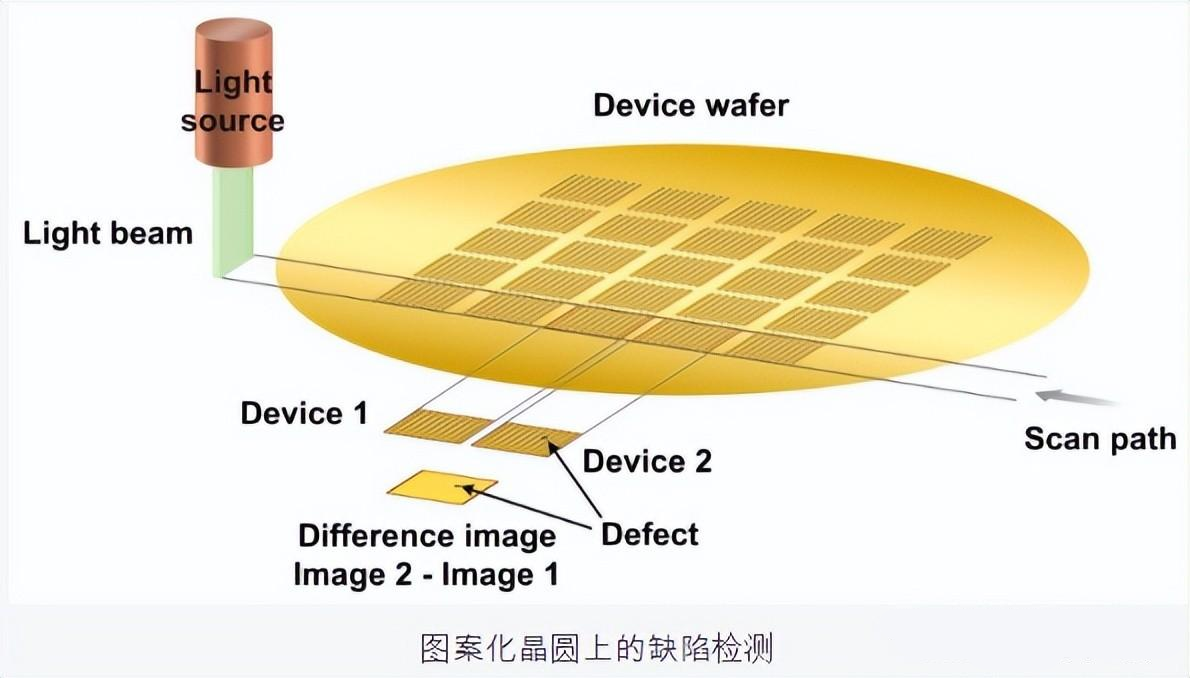
图案化晶圆检测系统可以通过将缺陷与相邻器件的图案图像进行比较来检测缺陷。
→相同的器件图案是在半导体晶圆的顶部制造的。随机缺陷由尘埃颗粒产生,并发生在随机位置。因此,在特定位置重复表现的可能性几乎不大。因此,如果将其与附近器件的图案图像进行比较,则可以检测到缺陷。
晶圆图案通过电子束或光沿着芯片阵列捕获。
→通过将要检查的器件的图案图像与附近的器件进行比较来检测缺陷。
如果没有缺陷,则从要通过数字处理检查的器件图像中减去附近的芯片图像的结果变为0,并且没有检测到缺陷。
相反,如果存在缺陷,则会在差异图像中留下缺陷,如上图所示。因此,检测到缺陷并将缺陷的位置标记为坐标。有了这些坐标信息,就能形成缺陷映射。
图案化晶圆检测使用明场成像、暗场成像或两者的组合进行缺陷检测。
使用这种方法进行晶圆检测是一个非常缓慢的过程。
热线电话:0755-23712116
邮箱:contact@shuangyi-tech.com
地址:深圳市宝安区沙井街道后亭茅洲山工业园工业大厦全至科技创新园科创大厦2层2A

