热线电话:0755-23712116
邮箱:contact@shuangyi-tech.com
地址:深圳市宝安区沙井街道后亭茅洲山工业园工业大厦全至科技创新园科创大厦2层2A
电子封装是衔接芯片与系统的重要界面,同时也是器件电路的重要组成部分。对电子产品而言,封装技术是非常关键的一环,封装工艺技术的进步推动着一代器件、电路的发展,牵动着整机系统的小型化和整体性能水平的升级换代。本期主要浅要介绍电子封装技术及发展,欢迎大家各抒己见,互相讨论交流。
电子封装概念
(集成电路)电子封装是半导体器件制造的最后一步,其是指将制作好的半导体器件放入具有支持、保护的塑料,陶瓷或金属外壳中,并于外界驱动电路以及其他电子元器件相连这一过程。经过封装后,半导体器件将可在更高的温度环境中工作,抵御物理损害与化学腐蚀,不仅能保护内置器件而且能起到电气连接、外场屏蔽、尺寸过渡、散热防潮、规格化和标准化等多种功能。

传统简易封装流程
电子封装技术发展
传统电子封装从最初的三极管直插时期后开始产生,其过程如下:将圆晶切割为晶粒(Die)后,使晶粒贴合到相应的基架板触垫(Leadframe Pad)上,再利用导线将晶片的结合焊盘与基板的引脚(Wire Bond)相连,实现电气连接,最后用外壳小心加以保护。典型的封装方式有:DIP,SOP,BGA等。
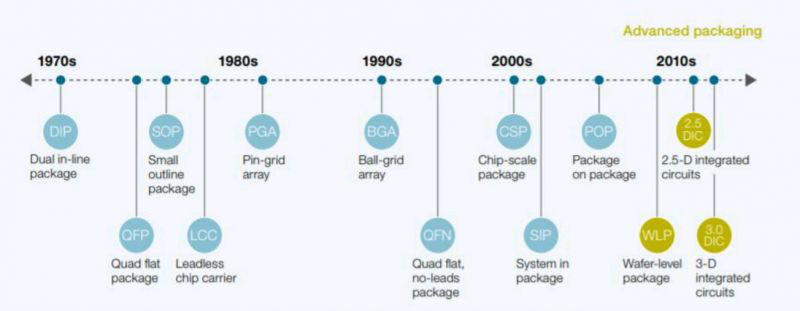
电子封装发展
DIP(Dual ln-line Package)双列直插形式封装技术,是最早模集成电路(IC)采用的封装技术,具有成本低廉的优势,其引脚数一般不超过100个,适合小型且不需接太多线的芯片。DIP技术代表着80年代的通孔插入安装技术,但由于DIP大多采用塑料,散热效果较差,无法满足现行高速芯片的要求,目前这种封装市场逐渐萎缩。

DIP封装
Small Outline Package(SOP)小外形封装技术和 Quad Flat Package(QFP)扁平封装技术代表了表面安装器件时代。这种技术提高了管脚数和组装密度,是封装技术的一次革命。正是这类封装技术支撑着日本半导体工业的繁荣,当时封装技术由日本主宰,确定了80%的收缩原则,同时也是金属引线塑料封装的黄金时代。
90年代进入了Ball Grid Array(BGA)焊球阵列封装及 Chip Scale Package(CSP)芯片尺寸封装技术时代。其中,BGA封装主要是将I/O端与基板通过球柱形焊点阵列进行封装,通常做表面固定使用。90年代后,美国超过日本占据了封装技术的主导地位。美国加宽了引线节距并采用了底部安装引线的BGA封装,引线节距的扩大极大地促进了安装技术的进步和生产效率的提高。
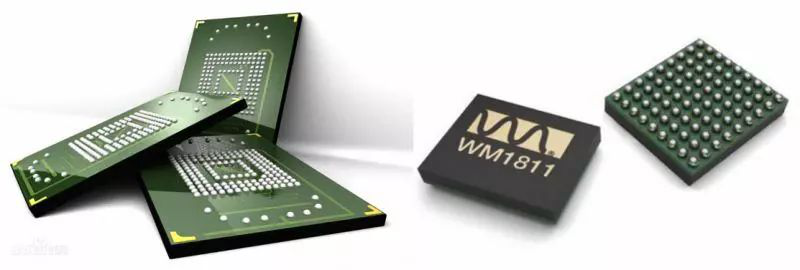
BGA&CSP封装
由于传统封装技术的封装效率较低(裸芯面积/基板面积)较低,不能满足电子器件的需求。在芯片制程受限的情况下,改进封装技术是唯一的选择。先进封装技术通过以点带线的方式实现电气互连,实现更高密度的集成,大大减小了对面积的浪费。
先进封装包括倒装(Flip-Chip),凸块(Bumping),晶圆级封装(Wafer Level Packaging,WLP),2.5D封装(interposer, RDL等),3D(Through Silicon Via,TSV,硅通孔)等技术。其中,SiP 技术以及 PoP 技术奠定了先进封装时代的开局,2D集成技术,如 WLP,Flip-Chip 以及3D 封装技术,TSV等技术的出现,进一步缩小芯片间的连接距离,提高了元器件的反应速度。
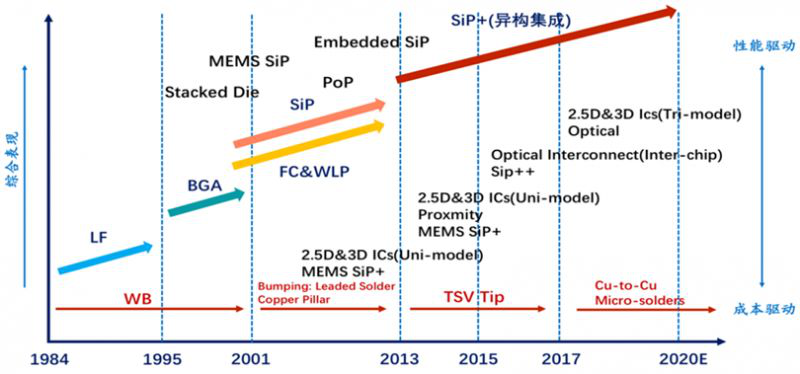
封装技术发展历程
从封装技术发展历程上看,封装结构主要朝着超高密度的方向发展,主要有两种发展方向,一是减小封装面积,使其接近芯片大小,主要的封装类型包括倒装(Flip-Chip),扇入型(Fan-in),扇出型(Fan-out)封装。二是增加封装内部的集成度,将多个Die封到一个封装内,实现超越摩尔定律,如SiP、3D封装等。
1路径一:尺寸减小方向
倒装(Flip-Chip)
Flip-Chip指芯片倒装,以前的封装技术是将芯片的有源区面朝上,背对基本和贴后键合。而Flip-Chip则是将芯片有源区面对基板,通过芯片上呈阵列排列的焊料凸点(Bumping)实现芯片与衬底的互联。硅片直接以倒扣的方式安装到PCB从硅片向四周引出的I/O上,互联长度大大缩短,减少了RC(Resistance-Capaictance)延迟,能效提高电性能。

引线键合工艺与Flip-Chip工艺对比
Flip-Chip最主要的优点是拥有最高密度的I/O数,与常规的引线键合相比,Flip-Chip由于采用了凸点结构,互连长度更短,互连线的电阻和电感值更小,封装电性能和器件可靠性、散热能力明显改善。
凸块(Bumping)
Bumping是一种新型的芯片与基板间电气互连的方式。可通过小的球形导体材料实现,这种导电球体被称为Bump,制作导电球这一工序被称为Bumping。当粘有Bump的晶粒被Flip-Chip与基板对齐时,晶粒很容易实现与基板触垫的连接。Bumping是Flip-Chip与PCB电连接的唯一通道,也是Flip-Chip技术中的关键环节。
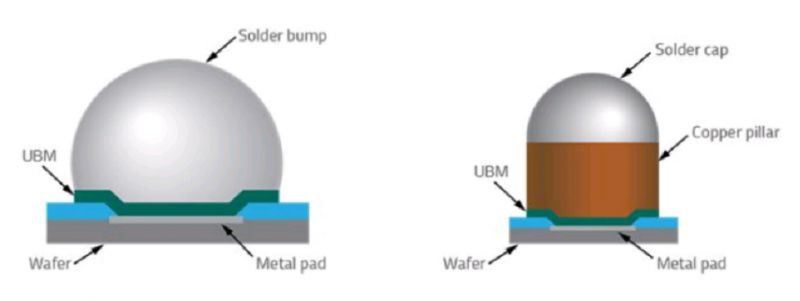
Bumping示意图(Semi engineering)
Bumping分为焊料和非焊料两大类,按制作方法分为焊料凸块、金凸块、聚合物凸块。凸块工艺直接影响倒装技术的可性能和性能可靠性。
晶圆级封装(Wafer Level Packaging,WLP)
在传统封装概念中,晶圆是先被切割成小的晶粒,之后再进行连接和塑封。晶圆级封装是对整片晶圆进行封装测试后再切割得到单个成品芯片的技术,封装后的芯片尺寸与裸片一致。WLP具有两大优势:①将芯片的I/O分布在IC芯片整个表面,使芯片尺寸达到微型化极限;②直接在晶圆片上对众多芯片封装、老化、测试,从而减少常规工艺流程,提高封装效率。
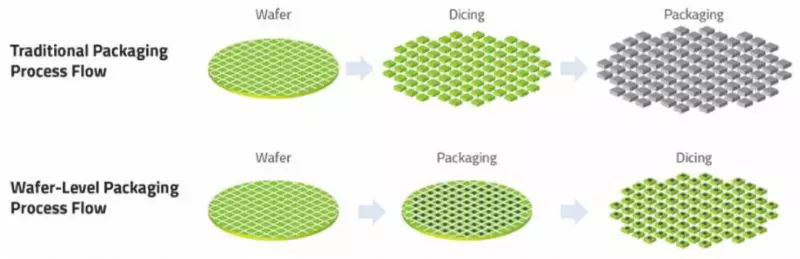
圆晶封装示意图(Semi engineering)
在WLP技术中有两大关键工艺:①薄膜再分布技术;②焊料凸块制作技术(Bumping)。其中薄膜再分布技术至在IC晶圆片上,将各个芯片按周边分布的的I/O焊区,通过薄膜工艺的再布线,变换成整个芯片上的阵列分布焊区,并形成Bumping的技术。主要再分布步骤及技术流程如下所示。
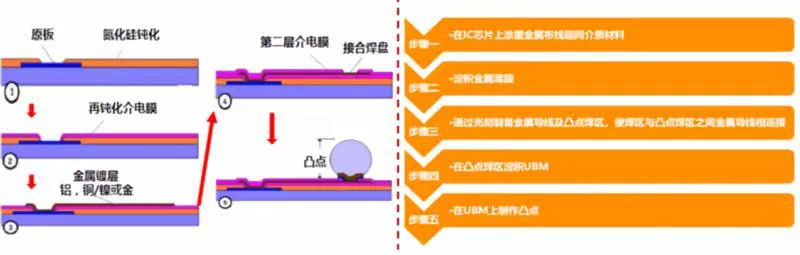
薄膜再分布技术工艺步骤及技术流程
扇出型圆晶级封装(Fan-out WLP)
传统的晶圆级封装(Fan-in WLP),其I/O数受到芯片面积限制,适用于低引脚数的消费型集成电路封装。随着集成电路信号输出引脚数目的增加,焊锡球的尺寸也变得越来越严格,PCB对集成电路封装后尺寸以及信号输出接脚位置的调整需求得不到满足,因此衍生出了扇出型圆晶级封装。

Fan-in 与 Fan-out 对比
Fan-out主要有两大优势,其一增加了I/O数目,其二采用RDL层布线代替传统IC封装所需的IC载板,大幅降低整体封装厚度。
2路径二:异质集成方向
系统级封装(System In a Package,SiP)
SiP指利用各种堆叠技术,将多个具有不同功能的芯片及被动元件集成到尺寸更小的封装元件上形成的一个系统。SiP可最大限度优化系统性能、避免重复封装、缩短开发周期、降低成本、提高集成度。
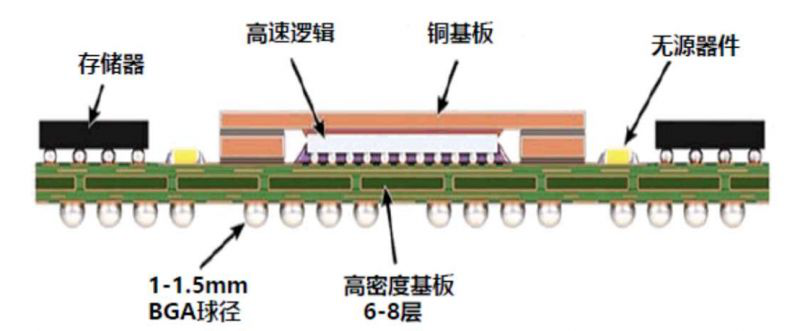
SiP封装示意图
SiP封装技术关键是晶片以2D、2.5D 还是3D方式接合到整合型基板。2D→2.5D→3D封装方式决定SiP的复杂度和完整度。目前单一封装体内不只可运用多个芯片进行系统功能构建,甚至还可将包含不同类型期间、被动元件、电路芯片、功能模组封装进行堆叠,透过内部连线或是更复杂的3D IC技术整合,构建成更为复杂的、完整的SiP系统功能。
3D封装
3D封装是指芯片在Z方向(垂直方向)上的垂直互连结构。3D封装可以大幅度缩小尺寸,减轻40-50倍重量,提升一倍硅效率,同时缩短延迟,降低成本。目前3D封装可通过引线键合、倒装凸块,POP(堆叠封装)、TSV(硅通孔)技术实现。
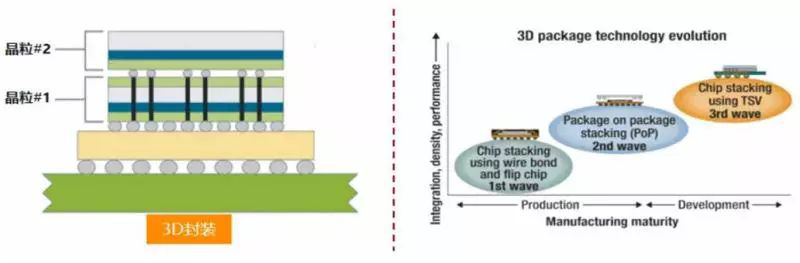
3D封装及其发展
TSV(硅通孔)技术
TSV是通过在芯片和芯片之间,晶圆和晶圆之间制造垂直通孔,通过Z方向通孔实现互联。TSV实现了贯穿整个芯片厚度的电气连接,更开辟了芯片上下表面之间的最短通路。与IC引线键合和使用Bumping技术不同,TSV能够在三维方向使得堆叠密度最大,而外形尺寸最小,大大改善芯片速度和低功耗性能。但由于技术目前成本较高,主要应用于图像传感器、粘结板、存储器、逻辑处理器、MEMS晶圆级3D等高端封装。
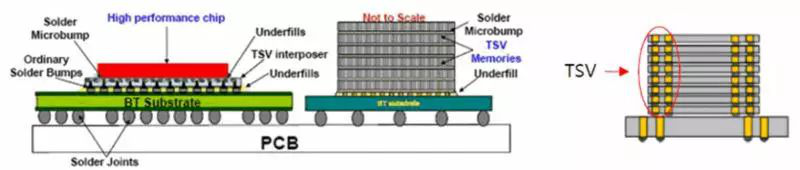
TSV技术示意图
从上述封装发展历程上看,封装结构主要沿着DIP→QFP→BGA→CSP→3D-SiP方向演进。封装结构演化过程中封装材料、引脚形状、装备方式以及键合方式也发生了相应的变化,主要趋势详见下表。

电子封装市场
电子封装行业属于半导体产业链的下游,位于圆晶制造之后,电子制造电路组装之前,是半导体行业链的必要一环。近年来,全球封测市场稳步增长,根据Gatner数据统计,2017年全球半导体行业收入4204亿美元,同比增长21.6%,其中封测行业收入占533亿美元,同比增长7.0%,占半导体行业收入的13%。

全球封测行业规模(Yole)
先进封装产值占封装总产值近一半,将引领未来发展。从全球封测市场产值看,据Yole数据显示,2017年先进封装产值超过20亿美元,占全球封测总产值近一半市场。先进封装由于可以提高封装效率,降低封装成本,提供更好的封装性价比,将是未来封测行业的主要发展方向。

全球先进封装市场规模(Yole)
深圳市双翌光电科技有限公司是一家以机器视觉为技术核心,自主技术研究与应用拓展为导向的高科技企业。公司自成立以来不断创新,在智能自动化领域研发出视觉对位系统、机械手视觉定位、视觉检测、图像处理库等为核心的20多款自主知识产权产品。涉及自动贴合机、丝印机、曝光机、叠片机、贴片机、智能检测、智能镭射等众多行业领域。双翌视觉系统最高生产精度可达um级别,图像处理精准、速度快,将智能自动化制造行业的生产水平提升到一个更高的层次,改进了以往落后的生产流程,得到广大用户的认可与肯定。随着智能自动化生产的普及与发展,双翌将为广大生产行业带来更全面、更精细、更智能化的技术及服务。